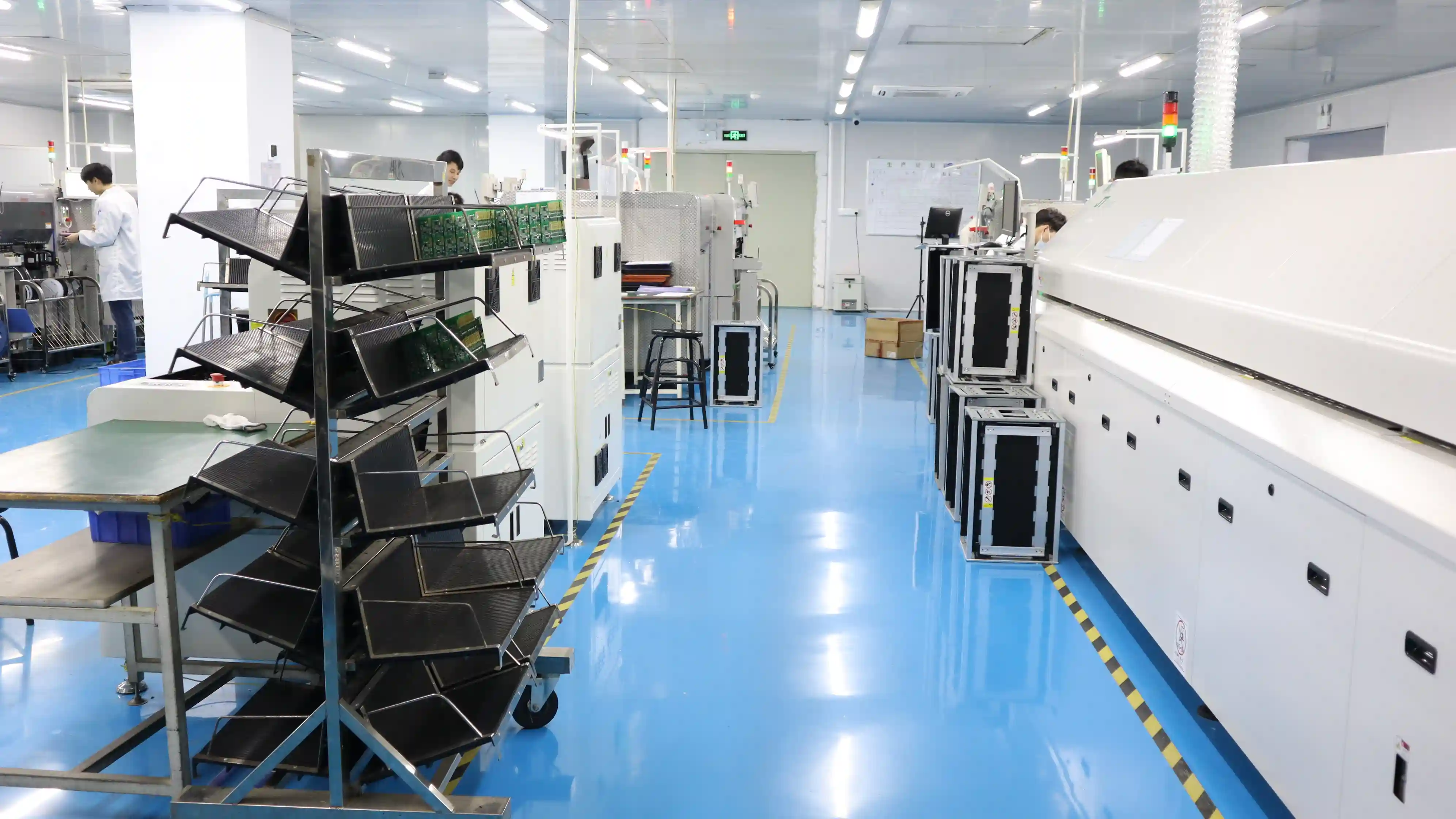
Sobre este Servicio
Especificaciones Técnicas
Características Clave
Aplicaciones
¿Por qué Elegirnos para Ensamblaje BGA?
Preguntas Frecuentes
¿Que archivos necesito para cotizar ensamblaje BGA?
Para cotizar ensamblaje BGA necesitamos Gerber u ODB++, BOM, centroides XY, archivo de pasta, cantidad objetivo y notas de ensamblaje. Si el BGA tiene requisitos MSL, underfill, perfil maximo o land pattern del fabricante, esos datos deben llegar en la RFQ. Con esa información revisamos pitch, via-in-pad, stencil, acabado superficial y necesidad de rayos X antes de confirmar precio y plazo.
¿Pueden montar BGA de pitch 0.4 mm o 0.3 mm?
Si, evaluamos BGA de 0.4 mm y algunos disenos de 0.3 mm, pero no los tratamos como montaje automatico. Antes de aceptar el pedido revisamos pad design, solder mask dam, via-in-pad rellena y tapada, acabado ENIG u otro acabado plano, espesor de PCB y panelizacion. En pitch fino, una desviacion pequena de mascara o warpage puede causar puentes u opens aunque la colocacion sea precisa.
Mi placa tiene BGA y necesito 50 unidades para validacion, ¿es demasiado pequeno?
No. Un lote de 50 unidades con BGA es adecuado para NPI si se prepara como validacion de proceso y no como una tirada economica sin control. Recomendamos revisar DFM, fabricar stencil dedicado, ejecutar first article inspection, usar rayos X en las primeras placas y documentar perfil reflow. Ese enfoque cuesta mas que montar a ciegas, pero evita repetir 50 PCBAs por un defecto oculto.
¿Es obligatorio usar rayos X en ensamblaje BGA?
Para BGA de producción seria, el rayos X es la forma practica de verificar juntas ocultas porque AOI no puede ver debajo del componente. Lo usamos para detectar puentes, bolas abiertas, desplazamiento y voids. En prototipos simples puede hacerse inspeccion selectiva, pero en BGAs de paso fino, FPGA, memoria DDR o aplicaciones medicas e industriales recomendamos rayos X como parte del plan de aceptacion.
¿Cuando debo elegir ensamblaje BGA en lugar de evitar ese encapsulado?
Conviene usar BGA cuando el producto necesita alta densidad de pines, mejor integridad electrica, tamano reducido o encapsulados como FPGA, SoC y memoria que no existen en formatos mas simples. Si el volumen es bajo, el presupuesto de test es minimo o la placa no puede soportar ENIG, via filling o rayos X, puede ser mejor redisenar con QFP/QFN o aumentar area de PCB.
¿Cual es la diferencia entre ensamblaje BGA y rework BGA?
El ensamblaje BGA monta componentes nuevos dentro de un lote PCBA planificado, con stencil, pick-and-place, reflow, inspeccion y trazabilidad desde el inicio. El rework BGA repara o reemplaza un componente ya soldado mediante remocion, limpieza, reballing o recolocacion. Si el objetivo es fabricar nuevas placas, use ensamblaje BGA; si necesita recuperar PCBAs fallidas, use rework BGA.
Garantía 100%
Si algo sale mal, lo repetimos gratis. Así de simple.